8.集微咨询发布《集微·国联安全球半导体景气度指数月度报告(2024年5月)》;
6月28日-29日,“跨越边界 新质未来”第八届集微半导体大会将在厦门国际会议中心酒店隆重举办。作为本届大会核心议程的“2024微电子学院校企合作论坛”将于29日下午同步举行。
本届论坛以“攻克关键核心技术、促进复合人才发展、推动科技成果转化”为核心,旨在汇聚高校、企业、园区、投资机构等多方力量和资源,搭建产业人才教育培训与科技成果转化的供需对接平台,将高质量科研成果转化为新质生产力,为产业高质量发展注入新动能。
同时,作为本届大会极具吸引力、影响力和感染力,且学术氛围浓厚的时空平台,论坛报名通道一经开启即受到业界广泛关注。各项事宜紧张筹备之际,大会组委会郑重揭晓来自北京大学、中国科学技术大学、复旦大学、东南大学、武汉大学、西安电子科技大学、北京理工大学、华中科技大学等30家国内知名高校的40余位学术界重磅嘉宾名单,他们将在本届论坛就“打造新质生产力、推动科技成果转化、建设产学研交流平台”等相关议题作深入探讨。
加速人才教育培训,深化产教融合已刻不容缓,“微电子学院校企合作论坛”也伴随集微峰会临近吹响了号角,并在众微电子学院及半导体产业链的支持下,本届论坛规模继续扩大。

伴随着集微半导体大会的号角,更基于上届论坛掀起的科技成果转化破题热,大会组委会持续“深耕细作”,全面升级迭代、打造多重亮点,推进科学技术创新的火花不断迸发,科研成果转化持续落地:
一、规模全新升级,多链深入衔接。嘉宾阵容、会议规模进一步全新升级,汇聚100多位高校微电子相关学科带头人,上市公司和细致划分领域有突出贡献的公司嘉宾,以及园区成果转化负责人、知名投资机构代表等,有力加强成果转化“新纵深”。
二、微电子科技成果转化项目墙。以高校实际的需求为出发点,收集微电子相关科技成果转化项目、成果,并以项目墙的形式在论坛中向与会嘉宾展示,将学校的科研成果转化、校企合作等需求及时向产业传递,深入推动创新链、产业链、资金链、人才链深度融合。
三、智慧支撑,重磅发布权威报告。本届论坛将发布《2023高校半导体专利数据分析报告》,分析全国高校专利数量、技术分布、申请趋势、专利类型、授权情况及专利布局等,探索当前技术趋势和前沿技术的发展趋势,为高校制定科研计划和推进成果转化提供重要参考。
四、“科技成果转化项目库”隆重揭晓。借助爱集微平台优势和多方资源,该“项目库”汇聚全国知名高校相关学院科技成果转化成果项目,搭建交流平台,帮助项目高效精准对接多方资源,切实全方面推进高校科技成果转化。
第八届集微半导体大会即将举办,诚邀集成电路行业人士及社会各界嘉宾拨冗参会,共襄盛举!
自2017年首次创办,集微半导体大会已连续举办七届,规模逐年扩大、影响日益增大。2024第八届集微半导体大会自报名通道开启以来,累计登记人数已逾千人!大会设置“1+50+1”办会架构(1个主论坛、50场专题论坛、1个半导体展),突出国际化、专业化、特色化,紧密衔接国家产业政策,重点拓宽国际视野。
2018年标志性的转变—使用碳化硅MOSFET替换传统硅基IGBT于主驱逆变器中,为碳化硅技术在电动汽车中的广泛应用奠定了基础。此后,多家国内新能源汽车领先品牌纷纷投身碳化硅器件的研发应用。新技术的不断涌现,如800V高压快充,以及新能源汽车市场的持续扩张,极大促进了碳化硅产业的飞速发展。
在新能源汽车取得巨大成功的背后,碳化硅功率模块扮演了举足轻重的角色。从传统功率模块转型到碳化硅功率模块,对功率电子模块及其封装工艺提出了更高的要求,尤其是芯片与基板的连接技术在很大程度上决定了功率模块的寿命和可靠性。传统的锡焊料由于熔点低、导热性差,难以满足封装高功率器件在高温和高功率密度条件下的应用需求。随着芯片工作时候的温度要求的不断的提高,至175°C甚至更高,连接技术的机械和热性能要求也随之提升。传统方法中常见使用锡焊将芯片做贴装的封装技术已无法满足大部分碳化硅模块的应用需求。随着800V碳化硅技术日益普及,烧结银技术为汽车电力电子科技类产品封装提供了革命性的解决方案,其应用前景备受关注。
贺利氏作为德国历史悠远长久的企业,始终致力于保持材料技术的创新与可持续发展。贺利氏电子中国研发总监张靖博士回忆,贺利氏电子烧结银技术在2007年已经相对完善,尽管当时还未发现具体的应用场景,但公司预见到未来对此类高性能材料的迫切需求,并进行了长远的技术储备。到了2015年,随着纯电动汽车的突破性发展,贺利氏电子的烧结银技术找到了与碳化硅电驱系统协同的完美应用场景。

汽车中碳化硅功率模块的广泛使用,对封装材料提出了日益苛刻的要求,特别是需要具备更高熔点、更强耐疲劳性、高热导率且低电阻率的连接材料。
传统功率模块中,芯片通常通过锡焊材料连接到基板。在热循环过程中,连接界面通过形成金属间化合物层完成芯片、锡焊料合金与基板的互联。目前电子封装中常用的无铅焊料熔点低于250℃,适用于低于150℃的服役温度。然而,在175-200℃乃至更高的使用温度下,这些连接层的性能将急速下降甚至熔化,极度影响模块的正常运行和长期可靠性。
张靖博士介绍,烧结银的独特优势主要体现在三个方面:高工作时候的温度—烧结银的工作时候的温度可达到300℃,甚至更高;高热导率—对于碳化硅模块这类小尺寸、高功率应用,能够有效导出热量,提高功率密度;以及高可靠性—其在汽车应用中的车规级要求极为严格,烧结银的高熔点、低蠕变倾向为整体系统提供了卓越的稳定性。烧结银技术因此很适合碳化硅功率模块的封装,完美满足了其对高工作时候的温度、高功率密度和高可靠性的严格要求。
自2007年起,贺利氏电子在烧结银材料的研发与生产方面走在行业前沿,提供多款产品以适应任何封装需求。从mAgic® ASP043、mAgic® PE338,到针对碳化硅应用的mAgic® PE338-28 F1510,贺利氏电子持续推动技术革新以满足市场的多样化需求。
烧结银技术作为封装领域的一个突破,凭借无铅、环保性和优异的导电导热性能获得了广泛关注。该技术已在市场上得到了大范围的认可。在逆变器系统中,烧结银可以被应用于芯片与基板的绑定,例如活性金属钎焊(AMB) 氮化硅材料上;或用于DTS烧结芯片顶部处理;或再将功率模块贴装到散热器底板上。
从芯片封装领域来看,此技术已广泛普及,很多现有量产或即将量产的车型已经采用烧结银来封装其碳化硅功率模块,一些传统的硅基IGBT考虑到功率密度与可靠性也有时采用烧结银方案。
因此,烧结银技术已从最初的小尺寸芯片贴片封装慢慢地过渡到更广泛的功率模块大面积应用。贺利氏电子在今年Semicon China 2024发布的针对功率模块贴装的大面积有压烧结银材料mAgic® PE350,在较低的烧结条件下展现出色的性能,实现了高效的散热效果。
“在功率电子材料设计中,寻找可靠性、工艺参数、工作时候的温度及性能之间的精细平衡至关重要。”张靖博士解释,从几平方毫米的芯片贴片到几十平方厘米的大面积模块,对烧结银材料提出了更多挑战。从传统芯片贴片烧结过渡到大面积烧结时,要解决多个技术问题以确保高质量的印刷和烧结效果。
首先,在大面积上进行印刷要求银膏的印刷性要足够好,需要调整银膏的触变性和黏度以适应大面积印刷。其次,为了适应大面积烧结,银膏的烧结性需要改进,以确保在较低的温度和压力下达到良好的烧结效果,并调整银膏的活性。同时,在大面积烧结过程中,必须精确并均匀地施加烧结压力和温度,以确保烧结质量的一致性和模块的完整性。
此外,大面积烧结会大幅度的增加对烧结银膏的用量,而烧结银成本相比来说较高,特别是与更传统的焊锡材料相比。尽管烧结银在性能上具有非常明显优势,但成本因素可能会影响某些客户的采用意愿。
“作为一种新兴技术,大面积烧结银需要一些时间让市场接受和适应。”张靖博士补充道,“有些客户对新技术的稳定性和长期效益保持观望态度。但随着慢慢的变多的碳化硅模块制造商、封装厂商乃至汽车制造商开始采用大面积烧结银工艺,相信未来大面积烧结技术在高端车型中的采用率会慢慢的高。”
今年开始,欧洲及其他海外市场可能由于各种各样的因素而显示出增长的放缓。与此同时,中国新能源汽车市场仍在稳步增长,部分市场如纯电动汽车的上涨的速度稍显缓慢,而混合动力汽车的比例较预期要高。然而,基于碳化硅的功率模块在这些市场中将继续发挥关键作用,贺利氏电子的烧结银技术在这一领域展示出巨大的市场潜力。
根据Yole预测,xEV正在推动功率模块封装材料市场的发展,2023年这一市场的成本约为23亿美元,约占功率模块总成本的30%,预计到2029年,功率模块封装材料的市场规模将翻倍增长至43亿美元,年复合增长率为11%。汽车应用将一直在改进模块材料和封装设计,以充分的发挥SiC技术的优势,同时重点通过良好的性能和可靠性来降低功率模块的成本。
贺利氏电子也在不断对烧结银材料技术来优化和升级。公司早期开发的产品mAgic® ASP043主要面向表面镀金或镀银的芯片。随技术的发展和市场需求的变化,慢慢的变多的用户对裸铜表面的烧结提出了需求。新一代产品mAgic® PE338不仅能在金银表明上进行烧结,也可以在裸铜表面上进行烧结。随着碳化硅应用的增多,碳化硅芯片与基板材料之间的热膨胀差异成为了一个重要问题。为了适应不一样材料之间的热膨胀,贺利氏电子在mAgic® PE338的基础上开发出新的mAgic® PE338-28 F1510版本,其热膨胀系数更接近于碳化硅芯片。
功率模块封装技术的重要趋势之一是在功率模块中慢慢的变多地使用碳化硅MOSFET作为Si IGBT的替代品,特别是在xEV应用中。这导致了对可承受更高结点和工作时候的温度的功率模块封装材料的日渐增长的需求,例如银烧结芯片粘接、先进的低杂散电感电气互连、Si3N4-AMB衬板、结构化底板以及高温稳定的封装材料。
张靖博士提到,随技术的不断演进和优化,烧结银技术在高工作时候的温度、高热导率和高可靠性方面的优势将越来越明显,贺利氏电子也在通过技术创新、工艺改进和产业生态合作来推动烧结银更广泛的应用。
与此同时,贺利氏电子也在探索烧结铜等新材料技术,以期开发出成本效益更高、性能更优的烧结材料。例如此前推出的magiCu PE401有压烧结铜,性能好价格低,能形成高导热及高可靠性的连接层,堪称提高电动汽车中功率电子器件的效率和常规使用的寿命的理想解决方案,适用于普通烧结设备。更终极的方案则是无压烧结铜,减少对设备和工艺的压力要求,使得烧结工艺的应用更方便快捷和广泛。
从烧结银行业生态来看,贺利氏电子一直希望能够通过上海研发中心这样的平台,结合产业链合作、高校联合研究、创新工程服务及周期性的技术研讨会等途径来进行新材料的本土化研发,普及烧结银技术,以促进新技术的接受和应用。最新的大面积烧结银mAgic PE350就是在中国本土研发的,再次展示了贺利氏电子“在中国,为中国”的承诺。
张靖博士提到,与传统的焊接工艺不同,烧结银需要专门的烧结设备来进行生产。在贺利氏电子研发该工艺的初期,由于市场上缺乏对应的烧结设备,公司在实验室内自行搭建了一套简易设备做试验。这不仅是一次自力更生的尝试,也是对材料和工艺进行微调以达到量产标准的过程。随后,公司与设备制造商进行了密切的合作,共同优化生产的基本工艺和材料配方,最终实现了烧结银材料的大规模生产。
至今,贺利氏电子与烧结设备制造商保持紧密的合作伙伴关系,在他们的设备上验证新材料的性能,同时一直在优化烧结材料以适应市场的新需求。此外,生产烧结银膏所用的银粉也需与相关供应商紧密合作,以确保满足多种烧结工艺和性能要求。
“贺利氏电子定期举办烧结银研讨会,为设备制造商、下游客户以及高校等行业各方搭建一个交流和学习的平台。”张靖博士说,“我们通过这一些会议分析市场趋势、分享烧结技术的基础知识,讨论烧结银材料和工艺参数的最新进展。会议结束后,参与者们还将前往贺利氏电子的创新工程服务中心做相关操作培训,与一线工程师面对面交流,亲身实践烧结银的工艺步骤,进一步加深他们对贺利氏电子mAgic烧结银创新产品和技术的理解。”
高校合作方面,贺利氏电子与中国多所知名大学,如复旦大学和上海交通大学建立了长期合作伙伴关系,这些合作大多分布在在烧结技术的基础研究和原理性探索上,帮助贺利氏电子保持其在烧结技术方面的先进性。
此外,贺利氏电子通过其上海创新中心提供工程服务,帮助客户解决技术难题,加速烧结银技术的商业应用。“目前贺利氏电子的上海创新研发中心从最初的600平方米扩展至超过1200平方米的实验室。”张靖博士强调,“我们的实验室配备了价值数千万人民币的全套设备,能够为客户提供从产品研发到量产的全方位支持。从2019年开始就在帮助合作伙伴完成烧结工艺工程服务,国内大部分碳化硅模块厂商都与贺利氏电子有过深度合作。我们大家都希望从贺利氏电子上海创新中心,能够走出更多客户的成功案例。”
随着烧结银技术的普及,封装材料市场的规模逐步扩大,也吸引了慢慢的变多的竞争者进入这一领域。尽管面临激烈的市场之间的竞争,贺利氏电子通过不断的研发和创新,已将其烧结银产品发展成为系列化产品,并在全球市场上拥有广泛的应用实例。

“材料研发和创新非一日之功,贺利氏电子的烧结银产品从诞生至今已近二十年,目前已形成了系列化产品,以及拥有广泛的应用实例。”张靖博士指出,未来,贺利氏电子仍将继续致力于提供广泛的电子封装材料组合、强大的应用与认证支持、以及定制化的工程服务,为客户提供全方位、本土化的咨询与研发服务,助力客户成功将前沿烧结技术应用于实际生产,满足市场对高性能功率器件一直增长的需求。
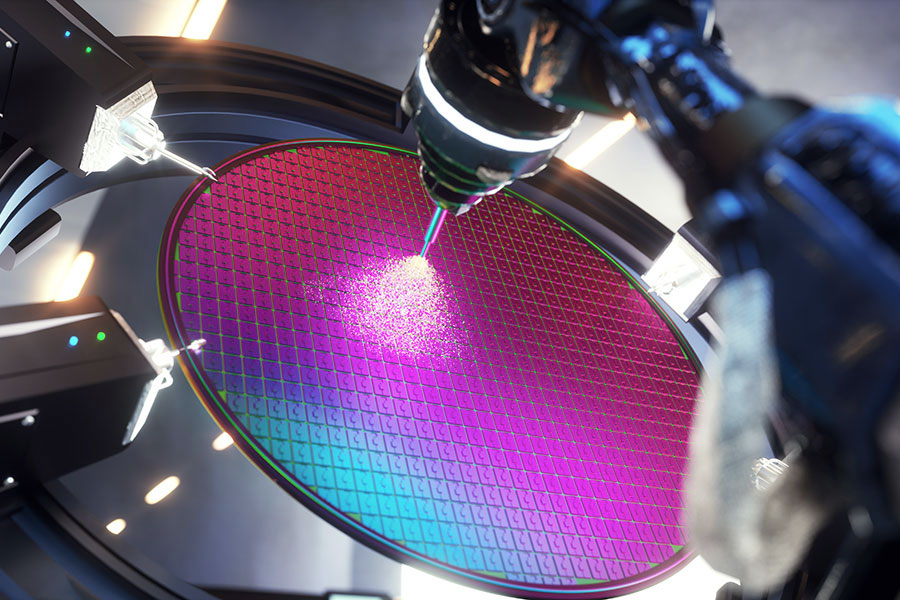
根据中国基金报消息,随着台积电传出将对3nm、5nm先进制程及先进封装实行价格调涨,有机构预计中国大陆晶圆代工厂如华虹半导体,下半年或将涨价10%,结束两年跌势。
目前中国大陆各大晶圆厂产能利用率显著提升,不少厂家已出现满产,甚至产能利用率超过100%的情况。业界认为,产能的持续提升以及代工厂满产,为未来价格持续上涨创造条件。
摩根士丹利(大摩)近日报告称,华虹半导体晶圆厂目前产能利用率已超过100%,预计今年下半年可能会将价格上调10%。
台积电凭借大量人工智能(AI)芯片订单,其3nm、5nm产能利用率保持高位,消息称3nm代工报价有望上涨5%以上。
机构多个方面数据显示,今年以来中国大陆功率半导体厂商集体涨价,其中三联盛全系列新产品上调10%~20%、蓝彩电子全系列新产品上调10%~18%、高格芯微全线%、捷捷微电Trench MOS上调5%~10%。
中芯国际此前提到,一季度其产能利用率为80.8%,环比提升4%,客户备货意愿有所上升,共出货179万片8英寸当量晶圆,环比增长7%。该公司透露,第二季度国际消费市场部分恢复,例如低功耗蓝牙、MCU等产品开始补单;得益于2024年体育年,电视、机顶盒有关产品销售增加,明显高于去年。
6月28日—29日,第八届集微半导体大会将在厦门国际会议中心酒店隆重举办。大会聚焦“跨越边界 新质未来”主题,汇聚众多国内外半导体领域知名专家及行业领袖,致力打造该领域权威的信息分享、产学研交流与合作沟通的综合互动平台。
第四届ICT知识产权发展联盟年会作为本届大会特色活动之一,将于6月29日下午同步举办。联盟理事会成员华为副总裁兼知识产权部部长樊志勇、OPPO首席知识产权官冯英、vivo知识产权总监徐显文、小米集团战略合作部总经理徐然、传音控股法务总监沈剑锋、荣耀知识产权部部长周文宇、TCL集团知识产权经理蒋忠凡、紫光展锐法务部部长杨洁静、宁德时代首席知识产权官孙明岩、北方华创合规副总裁宋巧丽、寒武纪知识产权总监胡帅等悉数到场。大会邀请来自通信、半导体、汽车、人工智能等领域头部企业,共议产业链上下游密切关注的专利运营、企业出海、337调查、商业秘密、数据安全等领域面临的风险挑战和应对措施。
届时,作为联盟理事长单位的爱集微将作《联盟工作年度汇报》,来自华为、小米、寒武纪、爱集微/紫藤等嘉宾代表进行主题演讲,并就“知识产权实践经验及问题探讨”进行互动,同时举行联盟新增会员仪式。本届联盟年会将一如既往地发挥ICT知识产权发展联盟作为政府和产业沟通桥梁的作用,助力企业在复杂的产业环境下蓬勃发展,凝聚多方共识、维护产业利益,不断扩大行业影响力。
创“芯”蝶变,追梦而来。经过紧锣密鼓的前期筹备工作,第四届ICT知识产权发展联盟年会议程正式公布!

ICT知识产权发展联盟隶属于中国通信工业协会,前身为“手机中国联盟”,旨在纵向延伸推动企业合作、知识共享及行业自律,横向拓展至通信以外的半导体、新能源汽车以及人工智能等更广泛的ICT产业,以应对国际市场上越来越多领域面临的专利诉讼和国外厂商垄断现象。
爱集微为联盟理事长单位,副理事长单位和理事单位包括华为、OPPO、VIVO、小米、传音、中兴、荣耀、TCL(紫藤)、宁德时代、紫光展锐、北方华创、寒武纪等。2011年成立以来,联盟配合主管部门进行多个国际反垄断案件的调查,曾代表成员企业与海外专利机构进行谈判磋商,广受行业认可。
第四届ICT知识产权发展联盟年会举办在即,诚邀产业嘉宾及社会各界人士拨冗参会,共襄盛举!
自2017年首次创办,集微半导体大会已连续举办七届,规模逐年扩大、影响日益增大。2024第八届集微半导体大会自报名通道开启以来,累计登记人数已逾千人!大会设置“1+50+1”办会架构(1个主论坛、50场专题论坛、1个半导体展),突出国际化、专业化、特色化,紧密衔接国家产业政策,重点拓宽国际视野。

针对市场传言台积电南京工厂已获得美国商务部“无限期豁免授权”的消息,近日,台积电官方回应表示,美国商务部近日已核发“经认证终端用户”(Validated End-User, VEU)授权予台积电(南京)有限公司。此项正式的VEU授权取代了之前商务部自2022年10月以来核发的临时书面授权。此VEU授权并未增加新的权限,而是确认了美国出口管制法规所涉及的物品和服务得以长期持续提供予台积电(南京)公司,供货商并不需要取得个别许可证。
台积电自 2015 年决定在中国南京投资兴建先进制程晶圆代工厂,正式命名为台积电(南京)有限公司,成为公司在中国大陆的重要制造基地之一。工厂位于南京市江北新区,占地约 30 公顷,是台积电在中国大陆的第一个 12 英寸晶圆代工厂。
2018 年 10 月,台积电南京工厂提前 6 个月投产,迅速展示了其在技术和生产效率方面的优势。工厂采用了先进的制程技术和自动化设备,年产能达到 10 万片 12 英寸晶圆,包括物理、化学和光学技术在内的生产线使其产品质量和性能达到全球领先水平。
英伟达周二 (18 日) 盘中股价涨逾 3%,市值达到 3.33 兆美元,超车微软成为全球市值最高的公司。本月早些时候,英伟达市值达到 3 兆美元,超越苹果 (AAPL-US) 市值。
今年以来,英伟达股价上涨 170% 以上,在该公司 5 月公布第一季财报后,股价进一步上涨。自 2022 年底以来,该股已成长逾 9 倍,同时也是生成式人工智慧 (generative artificial intelligence) 崛起时刻。
在数据中心的 AI 芯片市场上,英伟达的市占率约 80%。随着 OpenAI、微软、Alphabet(GOOGL-US)、亚马逊 (AMZN-US)、Meta(META-US) 等公司竞相抢购建构 AI 模型和运行日益庞大的工作负载所需的处理器,这项业务迅速膨胀。最近一季,英伟达数据中心业务的营收年增 427%,至 226 亿美元,约占该公司总销售额的 86%。
英伟达成立于 1991 年,最初的几十年主要是一家硬体公司,销售用于运行 3D 游戏的芯片,另外还涉足加密货币挖矿芯片和云端游戏订阅。
但在过去两年里,英伟达的股价一路飙升,因为华尔街开始意识到,该公司的技术是 AI 爆炸性成长背后的引擎,而这种爆炸性成长没有放缓的迹象。根据《富比士》(Forbes) 报导,该公司联合创办人兼执行长黄仁勋的净资产已超过 1,170 亿美元,在全球富豪榜上排名第 11 名。
另一方面,微软股价今年迄今上涨约 20%。这家软体巨擘也是 AI 热潮的主要受惠者,此前该公司收购 OpenAI 的大量股份,并将这家新创公司的 AI 模型整合到自家产品中,包括 Office 和 Windows。微软是英伟达用于 Azure 云端服务的图形处理单元 (GPU) 的大型买家之一。微软不久前才推出新一代笔记型电脑,专为运行其 AI 模型而设计,名为 Copilot+。
英伟达是美国最有价值公司的新成员,在过去的几年里,苹果和微软一直在交换这个头衔。
英伟达市值上升速度如此之快,以至于该公司上未被纳入道琼工业平均指数,这是一个由 30 档股票组成的基准指数,当中包括最有价值的美国公司。英伟达在上个月公布财报时,也宣布 1 拆 10 的股票分割计划,该计划于 1 月 7 日生效。
股票分拆让英伟达更有可能被纳入道琼指数。道琼指数是加权指数,这意味着股价较高 (而不是市值较高) 的公司对该基准指数的影响力过大。钜亨网
美股眼下最炙手可热的个股中,芯片制造商博通 (AVGO-US) 无疑占有一席之地。
博通股价周一 (17 日) 大涨 5.4%,收报 1828.87 美元,续创历史高点。根据《道琼市场》数据,博通市值 2 年多来首次超越礼来 (LLY-US),成为了美国市值第八高的公司。
截至周一收盘,博通市值已达到 8510 亿美元,礼来市值则超过 8411 亿美元。近来,博通市值接连跨越多个千亿美元关口,上周四 (13 日) 才首次突破 7000 亿美元,随后在上周五 (14 日) 便首次突破 8000 亿美元。
根据《道琼市场》数据,以目前的成分股计算,一年前博通在标普 500 指数中的市值排名还仅能排在第 16 位,而五年前更是只有第 52 位。
不可否认的是,博通先前完成的收购虚拟机器软体公司 VMware,对该公司市值的攀升起到了一些作用。根据 FactSet 数据,去年年底完成的收购为博通的市值增加了约 500 亿美元。
更关键的,无疑还当属博通眼下在 AI 浪潮中所受到的热烈追捧。博通上周三 (12 日) 发布的第 2 财季财报显示,在截至今年 5 月 5 日的第 2 财季中,每股获利为 10.96 美元,优于 10.8 美元的预期;营收成长至 125 亿美元,高于 121 亿美元的预期平均值。
博通是最新一批受到 AI 热潮提振的半导体制造商之一。博通的主要产品有乙太网路交换芯片、封包处理器、ASCI 等,其芯片被用来为业界底层软体提供动力。该公司表示,第 2 财季有 31 亿美元的销售额与人工智慧产品有关。
Piper Sandler 分析师 Harsh Kumar 写道,“我们持续认为博通是除了英伟达以外最好的人工智慧题材股,因为该公司在 ASIC 芯片领域中占有强有力位置,且有着强大的软体组合。”
Melius Research 科技研究团队负责人 Ben Reitzes 在被问及博通是否是“另一支”值得追逐的 AI 股票时,也持类似的观点。他写道,该公司的人工智慧收入较前一年成长 280%,正持续受益于其两大主要客户谷歌和 Meta 的庞大资本支出。钜亨网
8.集微咨询发布《集微·国联安全球半导体景气度指数月度报告(2024年5月)》;
由于半导体行业具有周期性强、产业链条长、行情波动大、投资难度高等特点,投资者往往很难把握住赚钱机会;跟踪、分析行业波动,对于半导体行业投资至关重要。集微咨询(JW Insights)携手A股场内规模最大的半导体ETF(512480)的掌舵人国联安基金,发挥半导体投资和产业研究的互补优势,共同发布“集微·国联安全球半导体景气度指数”。

“集微·国联安全球半导体景气度指数”,旨在打造反映“全球+中国”“基本面+情绪面”的一系列半导体行业景气度指标,赋予半导体行业投资者/从业者对于市场热度、行业趋势判断的衡量工具,搭建半导体行业景气度交流与服务平台,填补该领域空白。
“集微·国联安全球半导体景气度指数”涵盖:全球/中国半导体市场销售额、各细分产品营销售卖额、存储器价格、分销商库存/价格数据、终端产品销量、中国半导体产量/进出口数据、半导体上市公司月度/季度业绩,以及集微咨询(JW Insights)调研数据等10余个大类。
根据《集微·国联安全球半导体景气度指数月度报告(2024年5月)》,2024年5月,“集微·国联安全球半导体景气度指数”为52.53,保持在荣枯线。
具体表现为:全球/中国半导体市场销售额屡创佳绩,已经连续六个月保持同比增长;台积电、联电、日月光等代工、封测企业受益于高性能计算需求旺盛业绩表现良好,联发科、联咏等设计企业营收环比有所下滑;中国智能手机市场复苏势头良好,但汽车市场表现较为平淡,整体芯片库存去化明显;国内集成电路进口金额环比有所下滑。


2024年5月,集微·国联安中国半导体景气度指数在进出口指数和情绪指数的带动下,相比上月下降了0.14(修正后),为49.92,再度跌落荣枯线下方。

其中,就行业基本面而言,中国半导体市场景气度指数为54.05,相比上个月下降了1.75(修正后),主要是因为2024年4月中国半导体市场销售数据以及中国半导体集成电路进口金额本月下降。当前中国半导体市场情绪面指数依然低于行业基本面。

集微·国联安中国半导体情绪指数,由估值、成交、动量、外资、ETF规模五大类指标组成,在集微·国联安全球半导体景气度指数中所占权重为15%。
截至2024年5月22日,中证全指半导体指数H30184.CSI收于4304.84点,半导体情绪指数分值为21.19。处于情绪适中范围内,相比于4月略有上升。
从估值面来看,当前半导体情绪指数估值分项得分为23.10。从资金面来看,半导体ETF短期规模变动得分为32.15;北向资金对半导体板块的相对看好程度得分为23.61。从交易面来看,半导体板块成交活跃度得分为3.06,动量分项得分为24.03。相较于历史均值而言,整体半导体板块情绪活跃度适中。
本半导体情绪指数,立足提供直观的市场热度、投资者情绪刻画工具*,情绪值在0-100区间内变动,其中0-20代表情绪低点,20-60代表情绪适中,60-100代表情绪过热。

该部分主要分为半导体晶圆代工、封测企业月度营收和IC设计企业月度营收两部分。半导体晶圆代工以及封测企业经营数据,能够指引行业变化趋势,其中尤其是企业月度营收等高频数据,能够及时反映行业变化;在行业转入下行阶段,IC设计企业对行业的反映早于代工和封测企业。
2024年5月,IC代工、封测业子指数为指数为55.68,处于荣枯线月指数反映出,从晶圆代工以及封装测试的角度,行业处于复苏态势中,复苏态势在逐渐明确。
2024年5月IC设计业子指数为51.61,位于荣枯线,设计企业营收表现均有下降。

根据WSTS数据,2024年4月,全球半导体行业销售额为464.3亿美元,环比增长了1.13%,同比增长了15.96%,连续六个月保持同比增长。其中,中国半导体行业销售额为141.7亿美元,环比上月的141.4亿美元,环比增长了0.21%,同比大幅增长了23.76%,也是连续六个月同比增长,而且同比增幅显著高于全球其他地区。
集微咨询认为,无论是全球还是中国半导体市场销售额,从2023年2月触底之后,处于回升的状态。关注同比的变化情况,全球市场和中国市场均有两位数的涨幅,特别是中国市场涨幅达到23.76%,反映出当前半导体市场复苏的态势已较为明朗。
2024年5月全球及中国半导体市场销售额指数分别为52.05和52.46,均处于荣枯线上方,相比于上月,全球指数上升0.75,中国指数下降0.31。集微咨询认为,全球和中国半导体市场都是在复苏过程中,全球市场已经连续九个月位于荣枯线上方,中国市场也是连续七个月位于荣枯线上方, 反映出全球以及中国半导体市场处于稳健复苏进程中。

存储器行业在全球半导体市场中占比很大,约为30%左右,地位很重要。存储器价格的波动也是历年全球半导体市场规模起伏波动的重要因素,可以较好地反映半导体行业中短期库存周期的波动情况。
集微咨询分别跟踪DRAM和NAND Flash存储器价格。数据表明,占存储器市场份额更高的DRAM的价格自2021年4月开始处于下降趋势当中,目前处于低谷位置,但是我们看到2023年9月份以来,DRAM存储器价格有止跌企稳的趋势,近期DRAM价格波动较大,DRAM现货平均价为1.033;NAND Flash价格目前较为平稳,NAND现货平均价为2.976。同时,DXI指数自2023年8月以来触底反弹,已经持续九个月呈现指数上涨趋势,2024年5月DXI指数为31169.85。
当前整体存储器价格及产值指数为50.31,相比于上个月下降1.62,已连续九个月稳步站在荣枯线上方。

此外,《集微·国联安全球半导体景气度指数月度报告(2024年5月)》还详细介绍了芯片价格、库存、交期指数;终端产品(智能手机、汽车)出货量/销量;半导体设备;中国半导体集成电路进口金额(集成电路、存储器、设备);2024年4-5月份全球半导体上市公司业绩披露及指引等几大类调研数据。
集微·国联安全球半导体景气度指数,将持续跟踪与分析:全球和中国半导体市场销售额、半导体市场情绪/交易数据、各细分产品销售额、出货量以及终端数据、基本的产品价格数据、分销商库存/价格数据、中国半导体产量/进出口数据、半导体上市公司月度/季度业绩,以及线下产业调研数据等多维度数据信息,助力投资者更综合全面的了解全球与中国半导体行业景气度指标和发展趋势。
目前,《集微·国联安全球半导体景气度指数月度报告》已在爱集微官网与APP正式上线,欢迎登录爱集微官网、爱集微APP,首页点击“集微报告”栏目,即可进行订购。
【头条】vivo印度公司2名高管获释;2023手机行业十大新闻;费城半导体指数上涨65%;英伟达预购大量HBM3内存
日车厂关闭常州工厂;Meta元宇宙部门裁员;美国限制下,英伟达仍向中东销售先进AI芯片;传三星3nm良率低于20%无法量产
【退还】曝合创汽车又被员工拉横幅,要求退还跟投款;芯谷微电子微波器件及模组项目主厂房封顶;旺荣IGBT封装和模组生产基地项目签约安徽黟县



